Warum und wie GaN-Feldeffekttransistoren für effiziente Schaltnetzteilanwendungen mit höherer Spannung eingesetzt werden
Zur Verfügung gestellt von Nordamerikanische Fachredakteure von DigiKey
2023-01-26
Angesichts gesellschaftlicher und gesetzlicher Anforderungen ist Energieeffizienz eine Priorität für elektronische Systeme. Insbesondere bei Anwendungen, die von Elektrofahrzeugen bis hin zu Hochspannungskommunikation und industrieller Infrastruktur reichen, sind Effizienz und Leistungsdichte der Energieumwandlung entscheidend für den Erfolg des Designs.
Um diesen Anforderungen gerecht zu werden, müssen die Entwickler von Schaltnetzteilen von den klassischen Silizium(Si)-basierten Metalloxid-Feldeffekttransistoren (MOSFETs) und Bipolartransistoren mit isoliertem Gate (IGBTs) abrücken, da diese schnell an ihre theoretischen Grenzen stoßen.
Stattdessen müssen die Entwickler Bauelemente in Betracht ziehen, die auf Materialien mit großer Bandlücke (WBG) wie Galliumnitrid (GaN) basieren. GaN-Bauelemente schalten schneller als Si-Bauelemente, können höhere Spannungs- und Leistungspegel verarbeiten, sind bei einem gegebenen Leistungspegel viel kleiner und arbeiten mit einem viel höheren Wirkungsgrad.
In diesem Artikel werden die Grundlagen von GaN-FETs untersucht, ihre Vorteile gegenüber herkömmlichen Si-Bauelementen in Schaltkreisen aufgezeigt, Beispiele aus der Praxis von Nexperia vorgestellt und ihre Anwendung diskutiert.
Grundlagen der GaN-FETs
Die grundlegenden Elemente in Stromwandlerschaltungen sind Hochspannungs-Halbleiterschalter. Entwickler haben sich darauf konzentriert, die Leistung dieser Bauelemente durch folgende Maßnahmen zu verbessern: Verringerung der Leitungsverluste durch Reduzierung des Serienwiderstands im eingeschalteten Zustand, Verringerung der Schaltverluste durch Erhöhung der Übergangsgeschwindigkeiten und Reduzierung parasitärer Effekte. Diese Entwicklungsbemühungen waren im Allgemeinen bei Silizium-MOSFETs und IGBTs erfolgreich, aber die Verbesserungsrate hat sich verlangsamt, da der Betrieb dieser Bauelemente ihre theoretischen Grenzen erreicht.
Infolgedessen wurden in den letzten Jahren WBG-Bauelemente aus Siliziumkarbid (SiC) und GaN eingeführt, die inzwischen in Serie produziert werden. Diese Komponenten bieten höhere Betriebsspannungsbereiche, schnellere Schaltzeiten und einen höheren Wirkungsgrad.
Die Bandlücke eines Halbleiters ist die Mindestenergie, die erforderlich ist, um Elektronen anzuregen, damit sie aus ihrem gebundenen Zustand in einen freien Zustand übergehen und Strom leiten (Tabelle 1).
|
Tabelle 1: Eine Zusammenfassung der wichtigsten Eigenschaften, die Halbleiter mit großer Bandlücke - wie GaN und SiC - von Si unterscheiden. (Tabellenquelle: Art Pini)
Bauelemente, die mit Halbleitern mit breiter Bandlücke hergestellt werden, können bei viel höheren Spannungen, Frequenzen und Temperaturen arbeiten als herkömmliche Halbleitermaterialien wie Si. Die breitere Bandlücke ist besonders wichtig, damit die Komponenten bei viel höheren Temperaturen arbeiten können. Die hohe Temperaturtoleranz bedeutet, dass diese Komponenten unter normalen Bedingungen mit viel höherer Leistung betrieben werden können. WBG-Halbleiter mit einem höheren kritischen elektrischen Feld und höherer Mobilität haben den niedrigsten Drain-Source-Durchlasswiderstand (RDS(ON)), was die Leitungsverluste verringert.
Die meisten Materialien mit breiter Bandlücke haben auch eine hohe Geschwindigkeit der freien Elektronen, wodurch sie mit höheren Schaltgeschwindigkeiten arbeiten können.
Im Vergleich zu Si, das eine Bandlücke von 1,12 Elektronenvolt (eV) aufweist, sind GaN und SiC Verbundhalbleiter, deren Bandlücken mit 3,4 eV bzw. 3,3 eV etwa dreimal so groß sind. Das bedeutet, dass beide höhere Spannungen und höhere Frequenzen unterstützen können.
Die höhere Elektronenbeweglichkeit von GaN macht es viel geeigneter für Hochfrequenzanwendungen mit hoher Performance. Die schnelleren Schaltgeschwindigkeiten und höheren Betriebsfrequenzen, die durch GaN-Leistungs-FETs ermöglicht werden, führen zu einer verbesserten Signalsteuerung, zu passiven Filterdesigns mit höheren Grenzfrequenzen und zu niedrigeren Brummströmen. Dies ermöglicht die Verwendung kleinerer Induktoren, Kondensatoren und Transformatoren, was zu einer Verringerung der Gesamtgröße und des Gewichts führt.
GaN-FETs werden als Transistoren mit hoher Elektronenbeweglichkeit (HEMT) bezeichnet. Die hohe Elektronenbeweglichkeit ist eine Funktion der FET-Struktur (Abbildung 1).
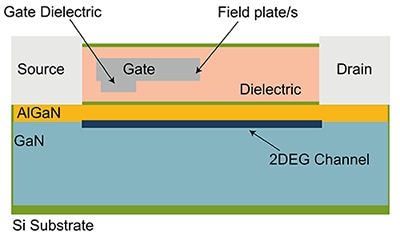 Abbildung 1: Ein Querschnitt durch einen GaN-FET auf einem Si-Substrat. (Bildquelle: Nexperia)
Abbildung 1: Ein Querschnitt durch einen GaN-FET auf einem Si-Substrat. (Bildquelle: Nexperia)
GaN-FETs nutzen bestehende Silizium-CMOS-Produktionsanlagen, was sie kostengünstig macht. Auf dem Si-Substrat wird eine GaN-Schicht gebildet, indem eine Keimschicht und eine abgestufte Schicht aus GaN und Aluminiumgalliumnitrid (AlGaN) als Isolationsschicht (im Diagramm nicht dargestellt) abgeschieden werden, bevor die reine GaN-Schicht wächst. Eine zweite AlGaN-Schicht wird auf der GaN-Schicht abgeschieden. Dadurch entsteht eine piezoelektrische Polarisation, wobei unmittelbar unter dem AlGaN ein hochleitender Kanal mit einem Überschuss an Elektronen erzeugt wird. Dieser Überschuss an Elektronen wird als zweidimensionales Elektronengas (2DEG) bezeichnet. Der Name spiegelt die sehr hohe Elektronenbeweglichkeit in dieser Schicht wider.
Unter dem Gate bildet sich eine Verarmungszone. Die Funktionsweise des Gates ähnelt der eines N-Kanal-Silizium-MOSFETs im Anreicherungsmodus. Eine positive Spannung, die an das Gate dieses Bauelements angelegt wird, schaltet es ein.
Diese Struktur wird mehrfach wiederholt, um eine leistungsstarke Komponente zu bilden. Das Ergebnis ist eine grundsätzlich einfache, elegante und kostengünstige Lösung für die Leistungsschaltung.
Um ein Bauteil mit höherer Spannung zu erhalten, wird der Abstand zwischen Drain und Gate vergrößert. Da der spezifische Widerstand von GaN 2DEG sehr niedrig ist, ist die Auswirkung auf den Widerstand durch die Erhöhung der Sperrspannungsfähigkeit im Vergleich zu Silizium-Bauelementen viel geringer.
GaN-FETs können so konstruiert werden, dass sie in einer von zwei Konfigurationen arbeiten: im Anreicherungsmodus oder im Verarmungsmodus. FETs mit Anreicherungsmodus sind normalerweise ausgeschaltet, so dass eine positive Spannung relativ zu Drain/Source an das Gate angelegt werden muss, um den FET einzuschalten. FETs mit Verarmungsmodus sind normalerweise eingeschaltet, so dass eine negative Gate-Spannung relativ zum Drain/Source angelegt werden muss, um den FET auszuschalten. FETs mit Verarmungsmodus sind in einem Stromversorgungssystem problematisch, da vor dem Einschalten des Systems eine negative Vorspannung an den GaN-Verarmungs-FET angelegt werden muss.
Eine Möglichkeit, dieses Problem zu umgehen, besteht darin, einen Niederspannungs-Silizium-FET mit einem GaN-FET im Verarmungsmodus in einer Kaskodenschaltung zu kombinieren (Abbildung 2).
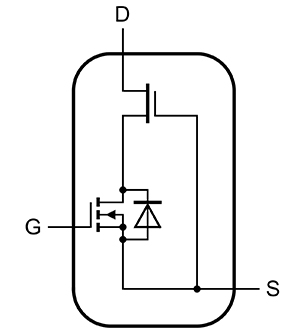 Abbildung 2: Ein Niederspannungs-Silizium-MOSFET in einer Kaskodenkonfiguration mit einem GaN-FET im Verarmungsmodus ergibt die Robustheit der Si-Gate-Struktur mit den verbesserten Hochspannungstakteigenschaften des GaN-Bauelements sowie - im Fall eines GaN-FET im Verarmungsmodus - das Ausschalten des zusammengesetzten Bauelements beim Einschalten. (Bildquelle: Nexperia)
Abbildung 2: Ein Niederspannungs-Silizium-MOSFET in einer Kaskodenkonfiguration mit einem GaN-FET im Verarmungsmodus ergibt die Robustheit der Si-Gate-Struktur mit den verbesserten Hochspannungstakteigenschaften des GaN-Bauelements sowie - im Fall eines GaN-FET im Verarmungsmodus - das Ausschalten des zusammengesetzten Bauelements beim Einschalten. (Bildquelle: Nexperia)
Die Kaskodenschaltung verwendet eine Si-MOSFET-Gate-Struktur, die den Vorteil hat, dass die Gate-Ansteuerungsgrenzen höher sind als bei bestehenden MOSFET-Gate-Treiber-ICs und dass der GaN-FET im Verarmungsmodus beim Einschalten ausgeschaltet ist.
Eine der wichtigsten Eigenschaften von GaN-FETs ist ihr hoher Wirkungsgrad. Die Gründe dafür sind: ein geringer Serienwiderstand, der die Leitungsverluste senkt, schnellere Schaltzeiten, die die Schaltverluste verringern, und eine geringere Rückspeiseleistung, die für die niedrigen Rückspeiseverluste verantwortlich ist.
Unter Verwendung einer gemeinsamen Halbbrücken-Aufwärtswandlertopologie ist es möglich, die Wirkungsgrade von GaN-FETs und Si-MOSFETs zu vergleichen (Abbildung 3).
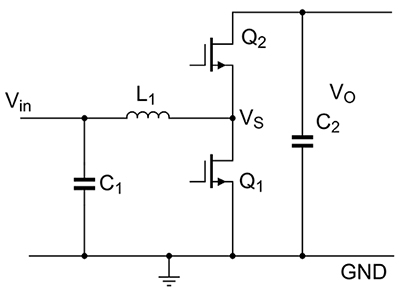 Abbildung 3: Die Abbildung zeigt das Schema eines Halbbrücken-Aufwärtswandlers, der für den Vergleich der Wirkungsgrade von MOSFETs und GaN-FETs verwendet wird, indem die Transistoren Q1 und Q2 mit dem jeweiligen Typ ausgetauscht werden. (Bildquelle: Nexperia)
Abbildung 3: Die Abbildung zeigt das Schema eines Halbbrücken-Aufwärtswandlers, der für den Vergleich der Wirkungsgrade von MOSFETs und GaN-FETs verwendet wird, indem die Transistoren Q1 und Q2 mit dem jeweiligen Typ ausgetauscht werden. (Bildquelle: Nexperia)
Der Aufwärtswandler hat eine Eingangsspannung von 240 Volt, die Ausgangsspannung beträgt 400 Volt und die Schaltfrequenz liegt bei 100 Kilohertz (kHz). Die Wirkungsgrade und Verluste werden über einen Leistungsbereich von bis zu 3500 Watt verglichen (Abbildung 4).
 Abbildung 4: Ein Vergleich des Wirkungsgrads und der Verlustleistung zwischen GaN-FETs und MOSFETs in einer identischen Schaltung, der die Vorteile der GaN-FETs zeigt. (Bildquelle: Nexperia)
Abbildung 4: Ein Vergleich des Wirkungsgrads und der Verlustleistung zwischen GaN-FETs und MOSFETs in einer identischen Schaltung, der die Vorteile der GaN-FETs zeigt. (Bildquelle: Nexperia)
Der Wirkungsgrad der GaN-FETs ist im Vergleich zu den MOSFETs um etwa 20 % höher, und die Verlustleistung ist etwa um den Faktor drei geringer. Bei 2000 Watt beträgt der Verlust bei den MOSFETs etwa 62 Watt; bei den GaN-FETs sind es nur 19 Watt. Das bedeutet, dass das Kühlsystem kleiner ausfallen kann, wodurch sich der volumetrische Wirkungsgrad des Aufwärtswandlers verbessert.
Weniger offensichtlich ist, dass die Messung für den GaN-FET aufgrund seiner höheren Maximalspannung bis fast 3500 Watt durchgeführt wurde. Der GaN-FET hat also einen klaren Vorteil.
Erste Schritte mit GaN für höhere Spannungen
Für Anwendungen mit höheren Spannungen bietet Nexperia zwei für 650 Volt ausgelegte GaN-FETs an, den GAN063-650WSAQ und den GAN041-650WSBQ. Beide sind N-Kanal-FETs, die normalerweise ausgeschaltet sind. Der GAN063-650WSAQ ist für eine maximale Drain-Source-Spannung von 650 Volt ausgelegt und kann eine Transiente (mit einer Pulsbreite von weniger als einer Mikrosekunde) von 800 Volt aushalten. Er ist für einen Drainstrom von 34,5 Ampere (A) und eine Verlustleistung von 143 Watt bei 25°C ausgelegt. Der Durchlasswiderstand zwischen Drain und Source beträgt in der Regel 50 Milliohm (mΩ), mit einer Obergrenze von 60 mΩ.
Der GAN041-650WSBQ hat die gleiche maximale Drain-Source-Spannung von 650 Volt und die gleiche Transientengrenze von 800 Volt. Der Unterschied besteht darin, dass er einen maximalen Drainstrom von 47,2 A und eine maximale Verlustleistung von 187 Watt bei Raumtemperatur verarbeiten kann. Sein typischer Kanalwiderstand beträgt 35 mΩ, mit einem Maximum von 41 mΩ.
Ein Nexperia-Referenzdesign mit dem GAN063-650WSAQ in einer Halbbrückenkonfiguration ist in Abbildung 5 dargestellt.
 Abbildung 5: Empfohlenes Design für eine Halbbrücken-Leistungsstufe mit den GaN-FETs GAN063-650WSA. Der Schaltplan zeigt nur den FET-Treiber und die Halbbrücken-Ausgangsstufe sowie die zugehörigen Komponenten. (Bildquelle: Nexperia)
Abbildung 5: Empfohlenes Design für eine Halbbrücken-Leistungsstufe mit den GaN-FETs GAN063-650WSA. Der Schaltplan zeigt nur den FET-Treiber und die Halbbrücken-Ausgangsstufe sowie die zugehörigen Komponenten. (Bildquelle: Nexperia)
Der Schaltplan zeigt den doppelt isolierten High/Low-Gate-Treiber Si8230, der zur Ansteuerung der Gates der GaN-FETs verwendet wird. Der Ausgang des Gate-Treibers ist über einen 30Ω-Gate-Widerstand mit dem Gate verbunden, der für alle GaN-Bauelemente erforderlich ist. Der Gate-Widerstand steuert die Ladezeit der Gate-Kapazität und beeinflusst damit das dynamische Schaltverhalten. Die R-C-Netzwerke zwischen Drain und Source der FETs tragen ebenfalls zur Steuerung des Schaltverhaltens bei. Die Gate-Ansteuerungspegel für den GaN-FET liegen zwischen 0 und 10 bis 12 Volt.
Die hohe Schaltgeschwindigkeit der GaN-FETs (typischerweise im Bereich von 10 bis 11 Nanosekunden (ns)) erfordert ein sorgfältiges Layout, um die parasitäre Induktivität zu minimieren, und die Verwendung von RC-Dämpfern zur Dämpfung von Schwingungen aufgrund von Spannungs- und Stromtransienten. Zwischen der Hochspannungsversorgung und der Masse sind mehrere RC-Dämpfungsglieder (R17 bis R19 und C33 bis C35) eingebaut. Die Dämpfungsglieder reduzieren das durch die Wechselwirkung zwischen dem GaN-FET und dem Bypass-Netzwerk verursachte Klingeln. Dämpfungsglieder sollten so nah wie möglich an den Drain des High-Side-FETs angeschlossen werden. Sie werden mit oberflächenmontierbaren Widerständen und Keramikkondensatoren mit niedrigem effektivem Serienwiderstand (ESR) implementiert, um die Leitungsinduktivität zu minimieren.
Das von R4, D1, C12 und C13 gebildete Bauteilnetzwerk ist eine Bootstrap-Stromversorgung für den High-Side-Gate-Treiber. D1 sollte eine schnelle Diode mit geringer Kapazität sein, da ihre Sperrschichtkapazität zu den Schaltverlusten beiträgt. R4 begrenzt den Einschaltladestrom; ein Wert im Bereich von 10 bis 15 Ω ist gut geeignet.
Fazit
Von Elektrofahrzeugen bis hin zu Kommunikations- und Industrieinfrastrukturen erfordert der Bedarf an höherer Effizienz der Energieumwandlung und Leistungsdichte eine Abkehr von klassischen Si-Strukturen. Wie gezeigt, bieten GaN-FETs durch höhere Betriebsspannungen, schnellere Schaltzeiten und einen höheren Wirkungsgrad einen Weg in die Zukunft für Designs der nächsten Generation. Standardkomponenten, die in einigen Fällen durch Referenzdesigns unterstützt werden, helfen den Entwicklern, ihre Projekte schnell umzusetzen.

Haftungsausschluss: Die Meinungen, Überzeugungen und Standpunkte der verschiedenen Autoren und/oder Forumsteilnehmer dieser Website spiegeln nicht notwendigerweise die Meinungen, Überzeugungen und Standpunkte der DigiKey oder offiziellen Politik der DigiKey wider.